ニュース
車載部品の実装信頼性を向上させる 「高耐熱性 二次実装アンダーフィル材料」 を製品化【パナソニック】
2018年9月3日
液状の樹脂材料で、半導体パッケージや電子部品の実装補強を実現
車載部品の実装信頼性を向上させる
「高耐熱性 二次実装アンダーフィル材料」
を製品化

パナソニック株式会社 オートモーティブ&インダストリアルシステムズ社は、車載部品の実装信頼性を向上させる「高耐熱性 二次実装アンダーフィル材[1] CV5794シリーズ」を製品化、2018年10月から量産を開始します。
ADAS(先進運転支援システム)や自動運転など車載システムの高機能化を背景に、実装される半導体パッケージは、配線微細化が進み、はんだ接合部の面積が小さくなることによる接合強度の低下が課題となっています。また、今後、IVI(次世代自動車通信システム)によるコックピットの情報集中化に伴い、半導体パッケージサイズの大型化が予想されています。このような中、当社は、独自の樹脂設計技術により、車載用途に適した実装信頼性と、大型半導体パッケージの生産性向上に貢献する高耐熱性 二次実装アンダーフィル材を製品化しました。
【特長】
優れた耐熱性で、車載部品の実装信頼性の向上に貢献
・温度サイクル試験:-55℃から125℃で5000サイクル合格※1
(当社従来品※2 3000サイクル以上)
・ガラス転移温度(Tg)[2] :180℃(業界最高※3) (当社従来品※2120℃)
・熱膨張係数(CTE)[3] :20ppm以下(当社従来品※2 50ppm)
高い流動性で、大型半導体パッケージ(20mm角以上)の実装補強にも対応
・粘度 1Pa・s以下(当社従来品※2 4Pa・s)
・対応パッケージサイズ:20mm角(当社従来品※2 10mm角)
冷蔵保存ができ、取り扱いが容易で、輸送コストの削減に貢献
・保存条件:5℃ (当社従来品※2 -20℃以下)
※1:計測条件:半導体パッケージ
(サイズ6mm角、ボールピッチ300μm、ボールサイズ200μm、ボール高さ145μm、
はんだ種類SnAgCu(スズ、銀、銅))、実装基板(サイズ30×30×0.978mm、レジスト厚み21μm)
※2:当社従来品:二次実装アンダーフィル材(品番:CV5350AS、CV5313)
※3:2018年9月3日現在、二次実装アンダーフィル材として(当社調べ)
【用途】
車載カメラモジュール、車載通信モジュール(ミリ波レーダー用モジュール)、車載ECU(電子制御ユニット)、次世代コックピット/IVI(次世代自動車通信システム) などへの半導体パッケージや電子部品の実装補強
【備考】
2018年9月5~7日までポートメッセなごやで開催される「第1回 名古屋オートモーティブ ワールド2018」に本製品を出品します。
【お問合せ先】
オートモーティブ&インダストリアルシステムズ社 電子材料事業部
https://industrial.panasonic.com/jp/products/electronic-materials/semiconductor-encapsulation/ecom-fine-flow/hr2nduf?ad=press20180903
【特長の詳細説明】
1. 優れた耐熱性で、車載部品の実装信頼性の向上に貢献
車載部材では、高温と低温下での実装信頼性の確保が重要です。特に、高温下での部材の実装強度を確保するため、耐熱性に優れた補強材が求められています。実装信頼性を高める為には、耐熱性が高く且つ、温度変化による伸び縮みが小さい材料が有効ですが、従来のアンダーフィル材に使用される速硬化の樹脂では、高いガラス転移温度(Tg)と低い熱膨張係数(CTE)は両立が難しく、耐熱性を高めることが困難でした。本材料は当社独自の樹脂設計技術、反応制御技術により、高いTg(180℃)を維持しつつ、低いCTE(20ppm)を実現しました。これにより本材料と基板間の熱収縮差を抑制し、はんだボール[4] にかかるストレスの低減を図りました。-55℃から125℃での温度サイクル試験で5000サイクル以上でも、はんだ接続部分の剥離やクラックが発生せず、車載部品の実装信頼性の向上に貢献します。
2.高い流動性で、大型半導体パッケージ(20mm角以上)の実装補強にも対応
車載情報通信システム等の多機能化、集約化が求められており、半導体パッケージのサイズが拡大化する傾向が予想されます。従来材料は、補強材の耐熱性確保の為に流動性が損なわれており、大型サイズの半導体パッケージでは、均一且つ十分に補強材が充填できないことが課題でした。本材料は当社の樹脂設計技術、フィラー制御技術により、高い流動性を実現し、20mm角以上の半導体パッケージの実装補強に対応できます。
【流動性試験】
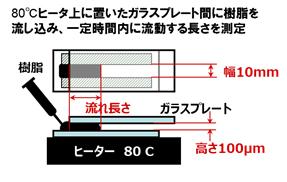

3.冷蔵保存ができ、取り扱いが容易で、輸送コストの削減に貢献
従来は、材料の特性上、冷凍保存(-20℃以下保存)が必要で、お客様の取り扱い時の負担や保管・輸送時の温度管理が難しいという課題がありました。本材料は当社独自の反応制御技術により、冷蔵保存(5℃)での保管を実現しました。これにより、お客様の生産時の取り扱いや輸送時の温度管理が容易となり、ドライアイス等の補材が不要になることでコスト削減に貢献します。
【基本仕様】

【用語説明】
[1] 二次実装アンダーフィル材
半導体パッケージや電子部品などをマザーボードなどのプリント配線板に、電気的に接続できるように配置することを二次実装といい、その際、接続信頼性を維持・向上させるために使用する補強材。液状樹脂タイプで、半導体パッケージの周囲に塗布することで基板とパッケージ間に侵入し、その後、熱硬化させることで不溶不融の硬化物となる。
[2] ガラス転移温度(Tg)
高分子などを加熱した場合にガラス状の硬い状態から柔らかいゴム状態に変わる現象をガラス転移といい、ガラス転移がおこる温度をガラス転移温度という。
[3] 熱膨張係数(CTE:Coefficient of thermal expansion)
一定の圧力下で温度を変えた時、単位温度あたりの材料の長さが増加する割合のこと。熱膨張係数は実装信頼性に影響を与える重要な特性の1つである。
[4]はんだボール
はんだとは、電子部品などのはんだづけに使用される合金である。半導体パッケージや電子部品などとプリント配線板との電気信号のやり取りをするために、互いの端子を電気的に接続した状態で固定するために使われる。はんだボールは、BGA(ボールグリッドアレイ)基板など片面封止タイプのパッケージなどを固定する際にパッケージ側に予め付けられる球状はんだのこと。
パナソニック株式会社ホームページはこちら




