ニュース
パワー半導体向けシンタリング装置を開発【日機装】
2022年10月3日
パワー半導体向けシンタリング装置を開発
~特殊ゲルを用いた立体的なプレスでSiCパワー半導体を均一に一括接合~
日機装株式会社は、パワー半導体SiCモジュールの製造におけるシンタリング(焼結)装置「3Dシンター」を開発しました。
日機装株式会社(本社:東京都渋谷区、以下「当社」)は、パワー半導体SiCモジュールの製造におけるシンタリング(焼結)装置「3Dシンター」を開発しました。
「3Dシンター」は、EVで採用が急増中のSiCパワー半導体の基板への接合工程において、当社独自の3Dプレス方式により、SiCチップと基板をシンタリング接合する装置です。特殊ゲル状加圧媒体を用いた立体的なプレスで、高さが異なるチップや基板を均一に一括接合できるため、従来の平面で加圧するメタルプレス方式と比べて、効率的かつ高品質なモジュールの製造が可能となります。

|
■特徴
1. 立体的な加圧で高品質なモジュールの製造が可能
従来のメタルプレス方式は、チップ部分のみへの平面的な加圧となるため、フィレット部を加圧焼成できません。そのため、フィレット部が脆くなり、モールディング工程で欠けが発生する可能性あることや、ヒートサイクルでの信頼性・耐久性に課題がありました。本装置は、特殊ゲルでフィレット部も立体的に均一に加圧することで欠けの発生を防ぎ品質向上に貢献します。
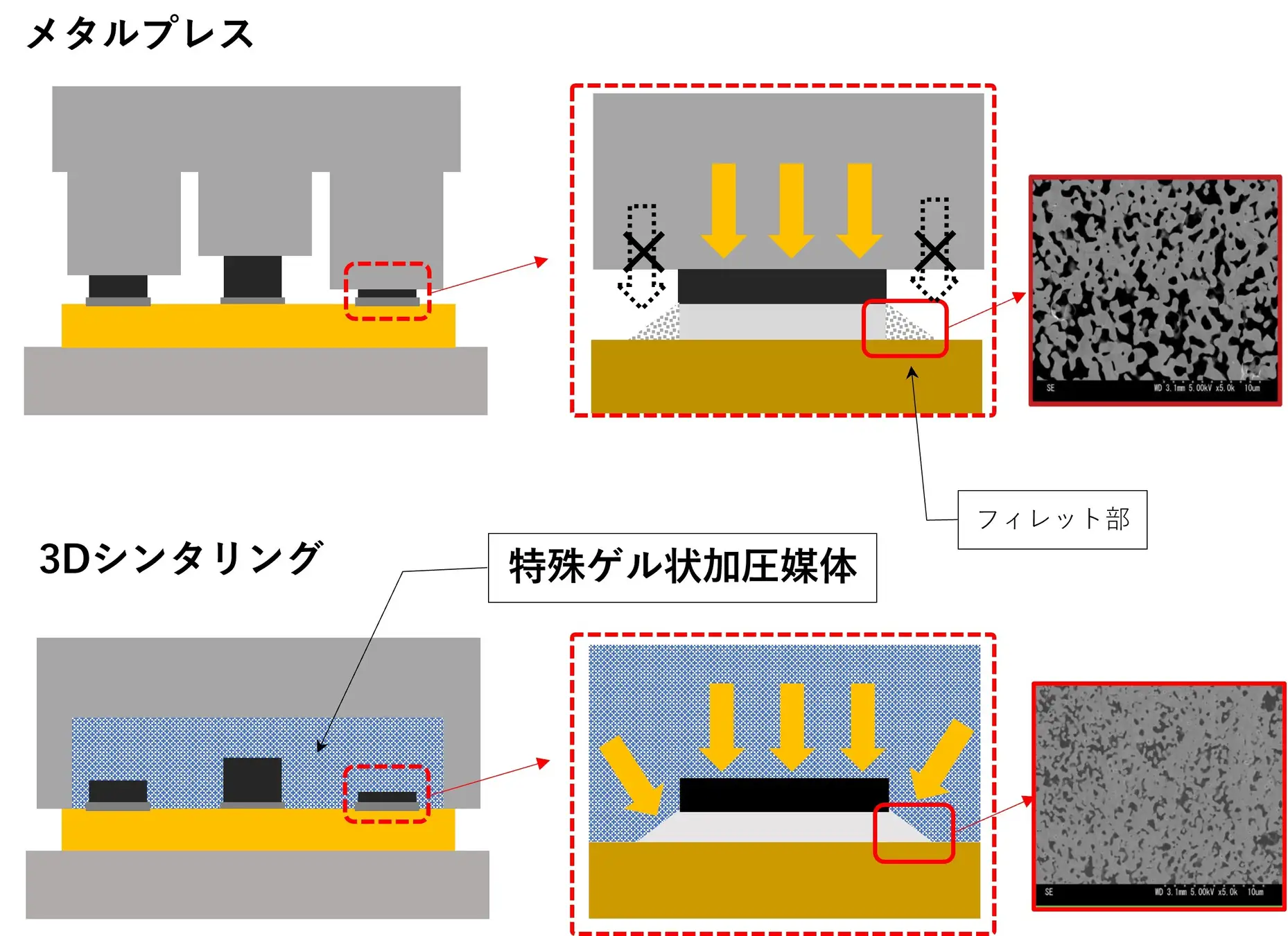
|
2. 様々なサイズを一括で接合
従来のメタルプレス方式では、サイズや高さの異なるチップや基板に対応するために、都度金型を交換する必要がありましたが、本装置では、複数の高さが異なるチップや基板を一度に均一に加圧することが可能なため、生産性の向上に貢献します。
3. ランニングコスト削減
本装置は、基板やチップ種別毎の高額な金型を制作して運用する必要がないため、大幅なランニングコストの削減が可能です。
■開発の背景
これから普及が進むパワー半導体においては、動作環境が高温になることから、従来半導体の接合で一般的であったハンダによる接合ではなく、銀や銅を素材とする焼結型接合材の採用が進んでいます。
当社は、MLCC(積層セラミックコンデンサ)の圧着工程において、水圧を利用した立体的なプレスで業界標準機として広く使用されている「温水ラミネーター」を提供しておりますが、今回この技術を応用した特殊ゲル状加圧媒体を用いることで、パワー半導体の接合特性に合ったシンタリング装置を開発しました。
■今後の展開
2022年10月から東村山製作所にデモ機設置、さらに2023年1月には上海にデモルームを開設し、順次販売開始する予定です。当社は今後も、均一加圧と均一加熱の技術を応用し、電子デバイス製造における新たな製造装置を開発してまいります。
<製品概要>
製品名: 3Dシンター DSシリーズ
販売日: 2022年10月3日
<日機装 会社概要>
会社名: 日機装株式会社
本社所在地 : 東京都渋谷区恵比寿4丁目20番3号恵比寿ガーデンプレイスタワー22階
創業 : 1953年12月26日
代表者 : 代表取締役社長 甲斐 敏彦
事業内容 : 産業用特殊ポンプ・システム、医療機器、航空機部品等の製造・販売
URL : https://www.nikkiso.co.jp/
日機装株式会社 ホームページはこちら




